概要


X線光電子分光分析法(XPS)による多層膜の深さ方向分析
概要
XPSの分析深さは表面から約10nmですが、Arイオン銃によるスパッタエッチングと測定を交互に繰り返すことにより、深さ方向の情報を取得することができます。ハードディスクや液晶コーティングなど、積層構造を持つ材料の解析に利用されています。
ここでは、多層膜Si基板の深さ方向分析の事例をご紹介します。
分析・試験装置
ESCA-3400HSE(島津製作所)
試料
多層膜Si基板(Si基板上にSiO2膜、MgF2膜、Al2O3膜を各100nm形成したサンプル)
分析・試験項目
深さ方向分析
分析・試験結果
Ar単原子イオンのスパッタエッチングにより、深さ方向分析を行いました。
エッチング時間(深さ方向に相当)を横軸、原子濃度を縦軸とした深さ方向分析結果(デプスプロファイル)を示します。横軸はエッチング深さ(SiO2換算、単位nm)で表示することも可能です。
深さ方向分析の結果、エッチング時間の増加に伴い組成が変化していく様子が確認できます。今回の試料は各100nmの膜をエッチングしていますが、材質によりエッチングのしやすさが異なるため、プロファイル上では膜厚が異なるように見えます。
XPSによる深さ方向分析は、元素組成の他、化学結合状態についても分布を調べることができることから、層構造や膜厚の評価に有効な手法です。
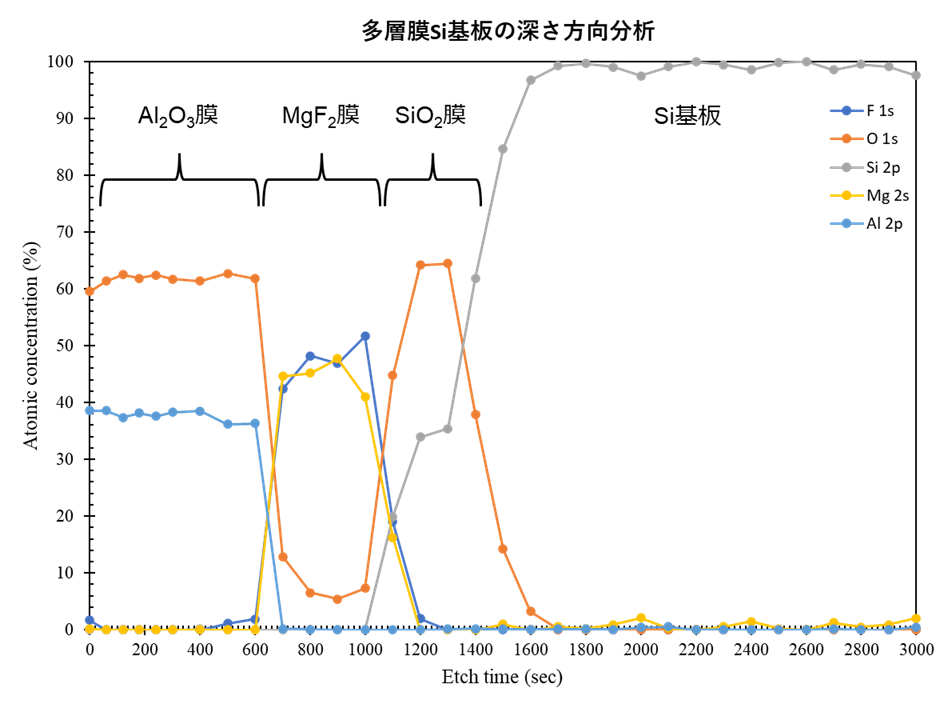
関連情報
分析・見積のご依頼・お問い合わせ
まずは、ご相談からご依頼まで、お気軽にお申しつけください。



