概要


X線反射率法(XRR)による薄膜の評価・解析
概要
薄膜材料において、薄膜の膜厚や膜密度は材料の性能や特性に大きく影響するため、定量的な評価が必要とされます。多目的X線回折装置(SmartLab 9kW)を用いたX線反射率法による薄膜の評価・解析では、設定した試料モデルを基に解析を行うことで、薄膜の厚さ・密度・ラフネス(表面・界面粗さ) を求めることができます。
分析・試験項目
● 薄膜の厚さ・密度・ラフネス(表面・界面粗さ)
● 薄膜の膜密度評価・膜厚評価(Si酸化膜・磁性材料・金属膜・有機EL・非晶質膜などの膜密度・膜厚評価)
● 積層膜の膜密度評価 界面層の密度評価・膜厚評価
分析・試験装置
- 型式 :多目的X線回折装置 SmartLab 9kW リガク製
X線源 :回転対陰極式Cuローターターゲット(出力:45kV・200mA、9kW)
光学系:集中法、平行ビーム法(薄膜法)、集光ビーム法、微小部測定
検出器:0次元、1次元、2次元検出器(HyPix-3000) 
多目的X線回折装置

装置内部の様子(ウエハ試料測定時)
試料
解析可能な薄膜
試料表面 :反りのない鏡面(表面粗さ 数 nm以下)
試料サイズ :10mm×10mm~4インチウエハ、厚さ20mm以下
膜厚 :2nm~300nm程度(試料による)
必要な情報 :膜構造および膜組成情報(特に多層膜の場合)
分析・試験方法
X線反射率法(XRR: X-Ray Reflectivity)では、試料表面すれすれにX線を入射させたときの入射角θに対する反射率を測定し、設定した試料モデルを基に解析を行うことで、薄膜の厚さ・密度・ラフネス(表面・界面粗さ) を求めることができます。
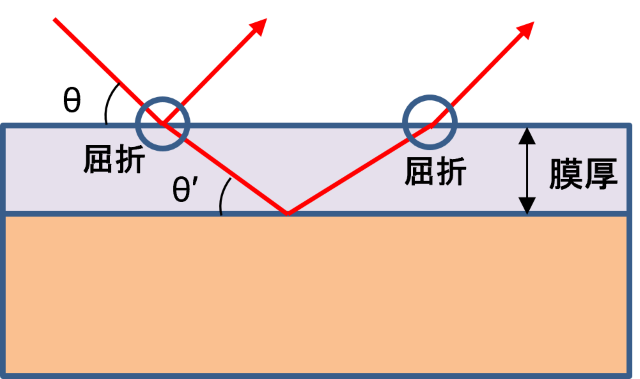
図 測定原理
特徴
● 試料の前処理を必要とせず、大気中で非破壊で測定可能
● X線の回折現象を用いないため、非結晶も測定可能
● 膜構造・組成情報があれば、多層膜もシミュレーションにより評価可能
分析・試験事例
表面ラフネス(表面粗さ)が異なるSi基板の評価
入射角度に対する強度減衰の依存性からはラフネス(粗さ)の情報を得ることができます。
一方で、減衰が大きくなりすぎると、反射率が十分に記録できなくなるため、測定可能な試料は表面や界面が十分に平坦(数nm 以下)なものに限られます。
XRR測定による表面ラフネスの評価は、類似した試料間での相対比較には便利ですが、より正確な評価には走査型プローブ顕微鏡(SPM/AFM)による表面分析を推奨します。

図 表面粗さが異なる基板の理論反射スペクトル
Si基板上に製膜された膜厚の異なるAu膜の評価
薄膜表面で反射したX 線と、薄膜と基板の境界において反射したX 線が干渉することにより、X 線反射率プロファイルに振動が表れます。振動の周期は膜の厚さに対応しており膜厚が厚いほど短い周期で振動します。
XRR測定による膜厚測定は、エリプソメータでは光が透過せず測定が困難となる金属膜や、蛍光X線では感度不足となる20nm以下の薄膜に対しても有効です。
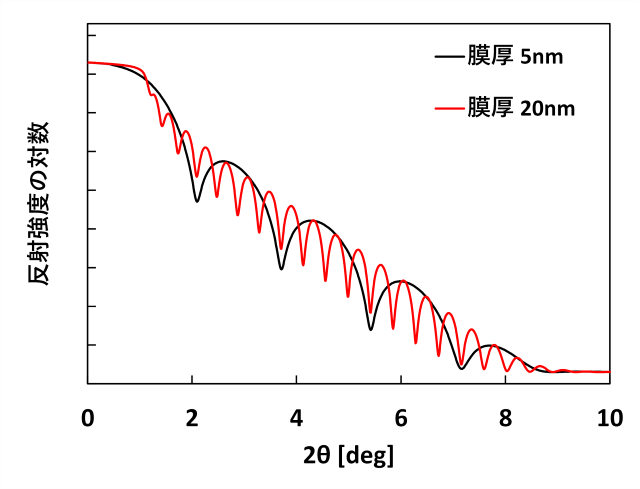
図 膜厚の異なるAu膜の理論反射スペクトル
Si基板上に製膜された膜密度の異なるAu, Ti, SiO2膜の評価
X線の全反射臨界角は表面の膜密度に依存しており、密度が高いほど入射角度が高い側で観測されます。さらに干渉による振動の振幅は膜と基板の密度差に大きく依存しており、密度差が大きい場合は振幅が大きくなり、密度差が小さい場合は振幅が小さくなります。
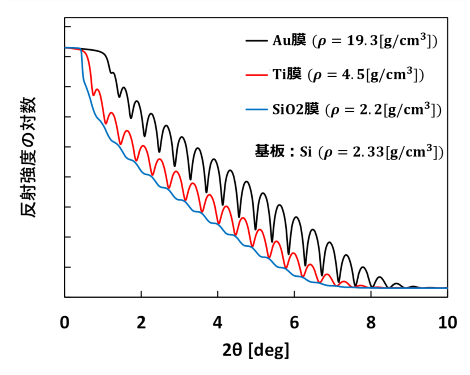
図 膜密度の異なる膜の反射スペクトル



